ВУЗ: Томский государственный университет систем управления и радиоэлектроники
Категория: Учебное пособие
Дисциплина: Электроника
Добавлен: 23.10.2018
Просмотров: 5398
Скачиваний: 12

106
рассеиваемой мощности на транзисторах, включенных по схемам
1 и 2, больше всего на 1—5 мкВт, что даже для интегральной
технологии несущественно.
Значительно меньшее значение обратных токов эмиттерных
переходов является очень важным, т. к. позволяет работать при
существенно меньших прямых токах, а следовательно, умень-
шить общую потребляемую мощность микросхемы.
Схема 1 обладает самым высоким быстродействием. За счет
глубокой отрицательной обратной связи не происходит накопле-
ния избыточных носителей, а, следовательно, время рассасыва-
ния практически равно нулю, что обеспечивает практически
мгновенное время восстановления обратного сопротивления.
Включение транзистора по схеме 5 нецелесообразно,
т. к. она объединяет всё худшее предыдущих схем.
11.6
Модель
интегрального
биполярного
транзистора
На рис. 11.10 приведена модель интегрального транзистора
типа n-
р
-n, аналогичная модели Эберса — Молла дискретного
транзистора. Она учитывает, что в структуре интегрального тран-
зистора, кроме основного n-
р
-n транзистора, имеется паразитный
р
-n-
р
транзистор. Диоды
1 —
3
VD
VD
— моделируют свойства
эмиттерного, коллекторного и изолирующего
р
-n переходов со-
ответственно.
Вольт-амперные характеристики этих диодов аппроксими-
руются формулами:
1
0
1 ,
БЭ
Т
U
Э
I
I
е
ϕ
⎡
⎤
=
−
⎢
⎥
⎢
⎥
⎣
⎦
2
0
1 ,
кб
Т
U
K
I
I
e
ϕ
⎡
⎤
=
−
⎢
⎥
⎢
⎥
⎣
⎦
3
0
1 ,
КП
T
U
И
I
I
e
ϕ
⎡
⎤
=
−
⎢
⎥
⎢
⎥
⎣
⎦
где
0
Э
I
,
0
K
I
,
0
И
I
— параметры модели, имеющие смысл тепло-
вых обратных токов эмиттерного, коллекторного и изолирующе-
го переходов. Положительными считаются токи I
1
, I
2
, I
3
, соответ-
ствующие прямым включениям переходов. Положительные
направления токов во внешних выводах эмиттера, базы, коллек-
тора и подложки показаны стрелками на рис. 11.10. Эти токи
совпадают с направлениями токов в активном режиме как для ос-
новного, так и для паразитного транзисторов. Напряжения между
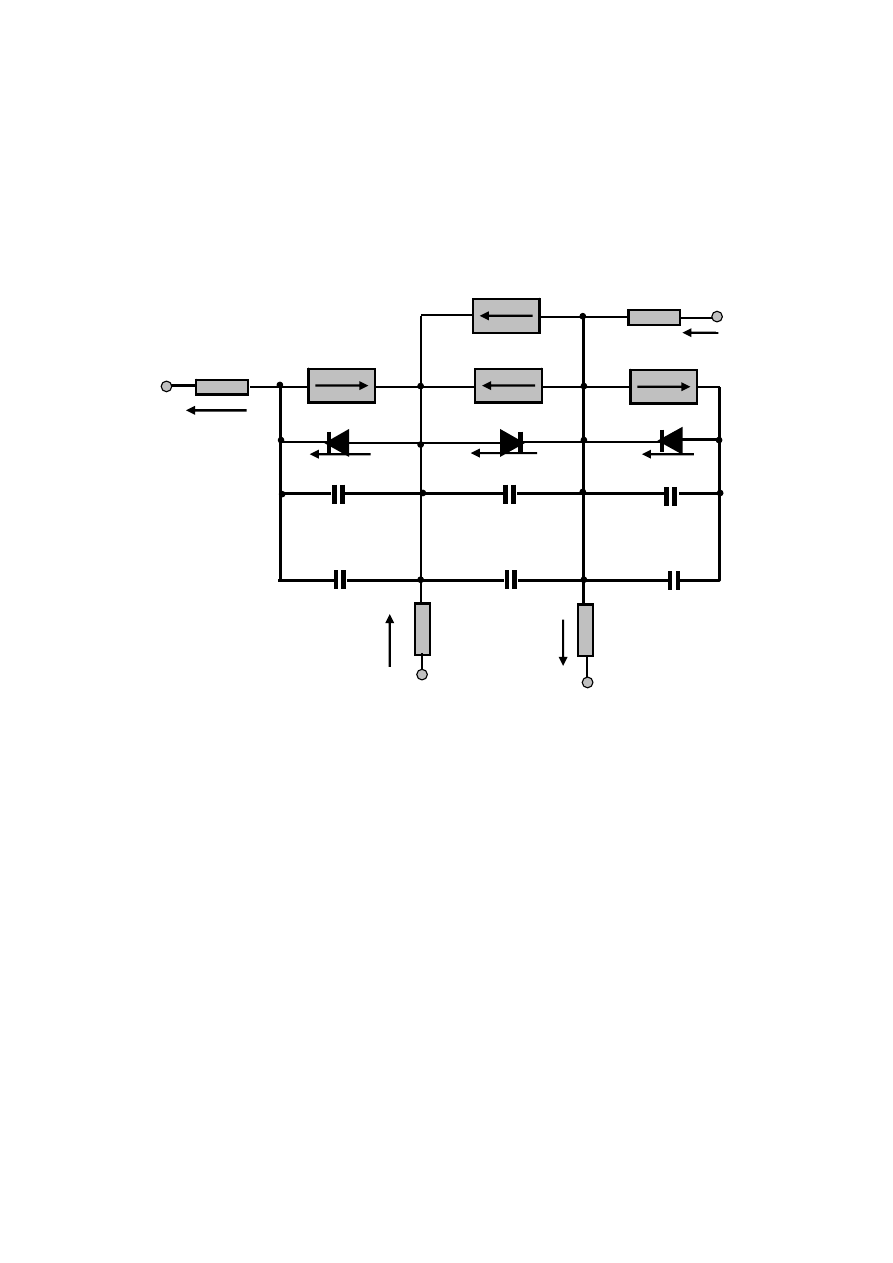
107
внешними выводами эмиттер — база
ЭБ
U
, коллектор — база
КБ
U
,
коллектор — подложка
КП
U
и напряжения на
р
-n переходах
1
ЭБ
U
,
1
КБ
U
,
1
КБ
U
считаются положительными, если соответствующий
переход включен в прямом направлении.
ά
1
I
2
ά
П1
I
3
ά
n
I
1
ά
П
I
2
I
К
r
1
Э
r
1
K
r
1
П
r
1
Б
I
Б
I
П
I
1
I
Э2
I
Э3
VD1
VD2
VD3
П
Б
Э
К
I
Э
С
Э бар
С
К бар
С
П бар
С
Э Д
С
К Д
С
П Д
Рис. 11.10 — Модель биполярного интегрального транзистора
Взаимодействие переходов транзистора учитывается че-
тырьмя генераторами тока. Генератор тока
1
n
I
α , включенный па-
раллельно диоду
2
VD
, учитывает передачу тока из эмиттера в
коллектор, а генератор тока
3
Пi
I
α
— из подложки в коллектор.
Здесь
Пi
α — инверсный коэффициент передачи паразитного
р
-n-
р
транзистора, а генератор тока
ПN
α , включенный параллель-
но диоду
3
VD
, из базы в подложку (
ПN
α — нормальный коэффи-
циент передачи паразитного транзистора). Статические парамет-
ры модели — тепловые обратные токи переходов и коэффициен-
ты передачи тока связаны между собой двумя соотношениями:
0
N Э
i
I
I
α
= α ,
0
1
0
П К
П
И
I
I
α
= α
.

108
Таким образом, из семи перечисленных параметров незави-
симыми являются пять. Модель интегрального биполярного
транзистора содержит четыре резистора:
1
э
r
,
1
Б
r
,
1
K
r
,
1
П
r
, учитыва-
ющих влияние сопротивлений полупроводниковых областей
эмиттера, базы, коллектора и подложки соответственно.
Сопротивления перечисленных резисторов являются пара-
метрами модели. Модель включает также барьерные и диффузион-
ные емкости переходов: эмиттерного
ЭБАР
C
,
ЭД
С
, коллекторного
КБАР
С
,
КД
С
и изолирующего
BБАР
C
,
ИД
С
, что позволяет использо-
вать ее для анализа работы транзистора в импульсном режиме.
МДП-транзисторы интегральных микросхем
В микросхемах наиболее широко распространены МДП-
транзисторы с индуцированными каналами n-типа. Транзисторы
со встроенными каналами используют реже, в основном как пас-
сивные элементы (нелинейные резисторы).
11.7
Полевые
транзисторы
с
управляющим
переходом
металл
-
полупроводник
Полевые транзисторы с управляющим переходом металл-
полупроводник являются основными активными элементами ар-
сенид галлиевых микросхем. Главная цель их разработки состоя-
ла в повышении быстродействия. Цифровые арсенид-галлиевые
микросхемы относятся к классу сверхскоростных, которые при-
меняются для работы в диапазоне сверхвысоких частот.
При разработке полевых транзисторов с управляющим пе-
реходом металл-полупроводник и микросхем на их основе ис-
пользуются следующие преимущества арсенида галлия по срав-
нению с кремнием: более высокие подвижность электронов
в слабых электрических полях и скорость насыщения в сильных
полях, большая ширина запрещенной зоны и, как следствие, зна-
чительно более высокое удельное сопротивление нелегированно-
го арсенида галлия, позволяющее создавать полуизолирующие
подложки микросхемы.

109
Простейшая структура МЕП-транзистора
Одна из первых структур арсенид-галлиевого МЕП-тран-
зистора (поперечный разрез) показана на рис. 11.11. Транзистор
создают на подложке 1 из нелегированного арсенида галлия.
Нелегированный арсенид галлия имеет слабо выраженную про-
водимость p-типа. Для ее уменьшения при выращивании моно-
кристаллов иногда вводят в небольших количествах атомы хрома,
компенсирующие действие акцепторов. Подложки, изготовлен-
ные из такого материала, обладают повышенным удельным со-
противлением, и их называют полуизолирующими.
У поверхности подложки методом ионного легирования фор-
мируют сильнолегированные области истока и стока
n
+
-типа,
а затем — тонкий слой канала n -типа. На поверхность подложки
над слоем 3 наносят металлический электрод 4 затвора З. Метал-
лические электроды 5, для которых применяют композицию зо-
лото-германий, обеспечивают омические контакты к областям
истокам и стока С. На поверхность подложки, не используемую
для контактов, наносят слой диэлектрика 6, например диоксида
кремния. Металлический электрод затвора образует со слоем 3
выпрямляющий контакт — барьер Шотки, типичная равновесная
высота которого 0,8 В. Проводящий канал между истоком и сто-
ком располагается в слое 3 и ограничен сверху обедненной обла-
стью 7 барьера Шотки, а снизу — подложкой.
И
1
2
2
3
4
5
6
7
Полуизолирующий GaAs
n
+
n
+
З
С
n
5
Рис. 11.11 — Структура МЕП-транзистора

110
U
ПОР1
U
ПОР2
U
ЗИ
U
ЗИ МАКС
I
C МАКС2
I
C МАКС1
I
1
3
2
Рис. 11.12 — Сток-затворные характеристики
МЕП-транзистора
Если напряжение на затворе равно пороговому
1
ПОР
U
, то
граница обедненного слоя 7 достигает полуизолирующей под-
ложки (толщина канала и ток стока равны нулю). Требуемое по-
роговое напряжение обеспечивают выбором концентрации доно-
ров в канале и толщины
0
d
слоя 3.
В арсенид-галлиевых микросхемах применяют МЕП-транзи-
сторы, для которых
2,5 — 0, 2
ПОР
U
B
= −
+
. Если
0
ПОР
U
< , то при
0
ЗИ
U
= канал является проводящим и транзистор называют нор-
мально открытым — он аналогичен МДП-транзистору с встроен-
ным каналом. При
0
ПОР
U
> и
0
ЗИ
U
= канал перекрыт обеднен-
ным слоем 7 и транзистор называют нормально закрытым, он
аналогичен МДП-транзистору с индуцированным каналом. На
рис. 11.12 приведены стоко-затворные характеристики нормально
открытого 1 и нормально закрытого 2 транзисторов, а также их
входная характеристика 3. Для нормально открытых МЕП-
транзисторов управляющее напряжение затвора, при котором
протекает ток стока, может изменяться от отрицательных значе-
ний, превышающих пороговое, до небольших положительных (не
более 0,6
В
). При больших положительных напряжениях на за-
творе в его цепи появляется нежелательный ток
З
I
, так как от-
крывается переход металл-полупроводник (кривая 3). Поэтому
ток стока ограничен величиной
.
1
С макс
I
. Для нормально закрытых
транзисторов напряжение затвора, при котором протекает ток
стока, положительное и может изменяться в пределах 0—0,6.