Файл: Научная работа включает 33 страниц, 18 иллюстраций и 3 использованных литературных источников.doc
ВУЗ: Не указан
Категория: Не указан
Дисциплина: Не указана
Добавлен: 11.12.2023
Просмотров: 118
Скачиваний: 1
СОДЕРЖАНИЕ
Введение…………………………………………………………………………………..3
1. Физика полупроводников…………………………………….......................................4
1.1 Зонная структура полупроводников…………………………. …………...4
1.2 Терминология и основные понятия………………………….. …………..5
1.3 Статистика электронов и дырок в полупроводниках…………………..6
1.4 Кон-ция Эл-в и дырок в примесном полупроводнике……………….....11
1.5 Определение положения уровня Ферми…………………………………12
1.6 Проводимость полупроводников………………………..............................13
1.7 Токи в полупроводниках………………………………………………….14
1.8 Неравновесные носители………………………………………………….15
1.9 Уравнение непрерывности………………………………………………..17
2. Полупроводниковые диоды…………………………………………………………….18
2.1. Характеристики идеального диода на основе p-n перехода……………..18
3.Транзисторы……………………………………………………………………………..21
3.1. Принцип работы транзистора…………………………………………………22
3.2.Параметры транзистора как элемента цепи…………………………………23
3.3.Типы транзисторов………………………………………………………………25
3.4.Технологические разновидности биполярных транзисторов……………...26
4.Программа расчета параметров диода и транзистора……………………………..27
Заключение………………………………………………………………………………...32
Список использованной литературы…………………………………………………..33
1.1. Зонная структура полупроводников
1.2. Терминология и основные понятия
1.3. Статистика электронов и дырок в полупроводниках
1.4. Концентрация электронов и дырок в собственном полупроводнике
1.4. Концентрация электронов и дырок в примесном полупроводнике
1.5. Определение положения уровня Ферми
2.1. Характеристики идеального диода на основе p-n перехода
3.1. Принцип работы транзистора
3.2.Параметры транзистора как элемента цепи
2.3. Характеристическое сопротивление
Различают два вида характеристического сопротивления диодов: дифференциальное сопротивление rD и сопротивление по постоянному току RD.
Дифференциальное сопротивление определяется как
На прямом участке вольт-амперной характеристики диода дифференциальное сопротивление rD невелико и составляет значение несколько Ом. Действительно, при значении прямого тока диода I = 25 мА и значении теплового потенциала kT/q = 25 мВ величина дифференциального сопротивления rD будет равнаrD = 1 Ом. На обратном участке вольт-амперной характеристики диода дифференциальное сопротивление rD стремится к бесконечности, поскольку в идеальных диодах при обратном смещении ток не зависит от напряжения.
Сопротивление по постоянному току RD определяется как отношение приложенного напряжения VG к протекающему току I через диод:
На прямом участке вольт-амперной характеристики сопротивление по постоянному току больше, чем дифференциальное сопротивление RD > rD, а на обратном участке – меньше RD < rD.
В точке вблизи нулевого значения напряжения VG << kT/q значения сопротивления по постоянному току и дифференциального сопротивления совпадают. Действительно, разложив экспоненту в ряд в соотношении (4.4), получаем:
Используя характерное значение для обратного тока диода I0 = 25 мкА, получаем величину сопротивления диода в нулевой точке RD0 = rD0 = 1 кОм.

Рис. 4.2. Приборные характеристики выпрямительных диодов
а) схема, иллюстрирующая выпрямление переменного тока с помощью диода; б) зависимость дифференциального сопротивления диода ГД402 от величины тока при прямом смещении; в) зависимость емкости диода от обратного напряжения
2.4. Влияние температуры на характеристики диодов
Как уже отмечалось, при прямом смещении ток диода инжекционный, большой по величине и представляет собой диффузионную компоненту тока основных носителей. При обратном смещении ток диода маленький по величине и представляет собой дрейфовую компоненту тока неосновных носителей. Зависимость тока от напряжения определяется соотношением:
Для несимметричного p-n+ перехода NA << ND концентрация неосновных носителей в p-области существенно выше, чем в n-области np0 >> pn0. Обратный ток в этом случае обусловлен дрейфовой электронной компонентой
 , поскольку
, поскольку Обратный ток диода в этом случае будет
Вблизи комнатной температуры Тк при ее небольших отклонениях можно записать:
Величина коэффициента для различных полупроводников будет следующей: для германия Ge = 0,09 град-1 до T = 700, для кремния Si = 0,13 град-1 до Т = 1200.
В практических случаях используют понятие температуры удвоения обратного тока диода. Соотношение (4.20) преобразуется к следующей форме, при этом
где
T* = 10; 8; 7; 5, при значениях = 0,07; 0,03; 0,1; 0,13.
Из соотношения (4.21) и значения температуры удвоения токаT* = 10 следует простое правило: обратный ток диода удваивается при увеличении температуры на каждые 10ºС.
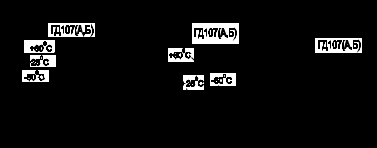
Рис. 4.8. Вольт-амперные характеристики диода ГД107
а) при прямом смещении б) при обратном смещении в) температурная зависимость прямого тока диода
3.Транзисторы
Биполярный транзистор представляет собой полупроводниковый прибор, состоящий из трёх областей с чередующимися типами электропроводности, пригодный для усиления мощности.
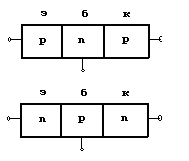
Эти области разделяются электронно-дырочными переходами(э-д переходами). Особенность транзистора состоит в том, что между его э-д переходами существует взаимодействие - ток одного из электродов может управлять током другого. Такое управление возможно, потому что носители заряда, инжектированные через один из э-д переходов могут до другого перехода, находящегося под обратным напряжением, и изменить его ток.
Каждый из переходов транзистора можно включить либо в прямом, либо в обратном направлении. В зависимиости от этого различают три режима работы транзистора:
1.Режим отсечки - оба э-д перехода закрыты, при этом через транзистор обычно идёт сравнительно небольшой ток;
2.Режим насыщения - оба э-д перехода открыты;
3.Активный режим - один из э-д переходов открыт, а другой закрыт.
В режиме отсечки и режиме насыщения управление транзистором почти отсутствует. В активном режиме такое управление осуществляется наиболее эффективно, причём транзистор может выполнять функции активного элемента электрической схемы.
Область транзистора, расположннная между переходами называется базой(Б). Примыкающие к базе оласти чаще всего делают неодинаковыми. Одну из них изготовляют так, чтобы из неё наиболее эффективно происходила инжекция в базу, а другую - так, чтобы соответствующий переход наиличшим образом осуществлял экстракцию инжектированных носителей из базы.
Область транзистора, основным назначением которой является инжекция носителей в базу, называют эмиттером(Э), а соответствующий переход эмиттерным.
Область, основным назначением которой является экстракцией носителей из базы - коллектор(К), а переход коллекторным.
Если на Э переходе напряжение прямое
, а на К переходе обратное, то включение транзистора считают нормальным, при противоположной полярности - инверсным.
Основные характеристики транзистора определяются в первую очередь процессами, происходящими в базе. В зависимости от распределения примесей в базе может присутствовать или отсутстввать электрическое поле. Если при отсутствии токов в базе существует электрическое поле, которое способствует вижению неосновных носителей заряда от Э к К, то транзистор называют дрейфовым, усли же поле в базе отсутствует - бездрейфовый(диффузионный).
3.1. Принцип работы транзистора
Когда ключ разомкнут, ток в цепи эмиттера(далее Э) отсутствует. При этом в цепи коллектора(К) имеется небольшой ток, называемый обратным током К и обозначаемый Iкбо. Этот ток очень мал,так как при обратном смещении К перехода потенциальный барьер велик и непреодолим для основных носителей- дырок коллектора и свободных электронов базы. К легирован примесью значительно сильнее, чем база. Вследствие этого неосновных носителей в коллекторе значительно меньше, чем в базе, и обратный ток К создаётся главным образом неосновными носителями: дырками, генерируемыми в базе в результате тепловых колебаний, и электронами, генерируемыми в К.

Замыкание ключа в цепи Э приводит к появлению тока в этой цепи, так как смещение эмиттерного p-n перехода в прямом направлении понижает потенциальный барьер для дырок, переходящих из Э в Б, и для электронов переходящих иэ Б в Э. Мы рассматриваем только дырки так как только они создают пририщение коллекторного тока. Говорят что дырки инжектируются в базу.
В базе обыкновенного транзистора электрическое поле отсутствует, поэтому дальнейшее движение инжектированых дырок определяется процессом диффузии. Так как толщина базы транзистора много меньше длины свободного пробега дырки до рекомбинации, то большая часть инжектированных дырок достигает коллекторного перехода, благодаря чему коллекторный ток усиливается. Лишь очень небольшая часть дырок рекомбенирует.