ВУЗ: Томский государственный университет систем управления и радиоэлектроники
Категория: Учебное пособие
Дисциплина: Электроника
Добавлен: 23.10.2018
Просмотров: 6053
Скачиваний: 13

96
дырочная составляющая тока этого перехода ниже, чем в струк-
туре без скрытого слоя.
В структуре транзистора, изолированного
р-n
переходом,
помимо основного
n-р-n
,
существует паразитный
р-n-р
транзи-
стор. Его эмиттер — базовый слой 5 (13) основного транзистора
(см. рис. 11.1), база — коллекторная область 2 со скрытым слоем
3, коллектор — подложка.
Схема включения паразитного транзистора представлена на
рис. 11.3. Его коллекторный (изолирующий) переход всегда сме-
щен в обратном направлении. Скрытый слой в коллекторе созда-
ет тормозящее электрическое поле для дырок, инжектированных
в коллектор из базы.
VT
ПАР
VT
ОСН
n-p-n
I
б
p-n-p
I
ут
I
б
1
SiO
2
Al
К
Б
Э
p
n
+
n
n
+
n
+
поликремний
Рис. 11.3 — Схема включения
основного и паразитного
транзисторов
Рис. 11.4 — Изоляция с помощью
диоксида кремния
Кроме того, время жизни дырок в скрытом слое мало, по-
этому уменьшается коэффициент передачи паразитного транзи-
стора, т. е. ток утечки.
Биполярные транзисторы являются наиболее сложными
элементами биполярных микросхем, так как их структура содер-
жит наибольшее число областей с различным типом проводимо-
сти. Другие элементы (диоды, резисторы) создаются одновре-
менно с транзисторами в едином технологическом процессе. По-
этому для них используют аналогичные полупроводниковые об-
ласти, которые принято называть в соответствии с областями
транзистора. Так, на основе базового слоя получают резисторы.

97
Эти элементы также размещают в специальных карманах, т. е.
изолируют от подложки тем же способом, что и транзисторы.
Наряду с биполярными транзисторами, изолированными
р-n
переходом, применяют биполярные транзисторы с диэлектриче-
ской изоляцией. Основные отличия структуры такого транзисто-
ра, которая приведена на рис. 11.4, от рассмотренной на рис. 11.1
состоит в том, что транзистор размещают в кармане. Карман изо-
лирован со всех сторон от подложки из поликристаллического
кремния тонким диэлектрическим слоем диоксида кремния. Ка-
чество такой изоляции значительно выше, так как токи утечки
в диэлектрике намного меньше, чем в
р-n
переходе, смещенном
в обратном напряжении. Удельная емкость диэлектрической изо-
ляции меньше, поскольку диэлектрическая проницаемость диок-
сида кремния приблизительно в 3 раза ниже, чем кремния, а тол-
щина диэлектрического слоя может быть выбрана больше тол-
щины изолирующего
р-n
перехода. Однако биполярные микро-
схемы с диэлектрической изоляцией не получили широкого при-
менения вследствие сложной технологии создания карманов
и малой степени интеграции. Их достоинством является повы-
шенная радиационная стойкость. У эпитаксиально-планарных
транзисторов токи утечки изолирующих
р-n
переходов резко воз-
растают при воздействии ионизирующего излучения, вызываю-
щего генерацию большого числа неосновных носителей. Ток
утечки диэлектрика при этом остается пренебрежимо малым.
Уменьшаются и токи утечки коллекторных
р-n
переходов, так как
основная масса неосновных носителей генерируется за пределами
карманов и не может достичь этих переходов.
11.2
Транзисторы
с
комбинированной
изоляцией
Основным методом изоляции элементов современных бипо-
лярных микросхем является метод комбинированной изоляции, со-
четающий изоляцию диэлектриком (диоксидом кремния) и
р-n
пе-
реходом, смещенным в обратном направлении. Существует боль-
шое число конструктивно-технологических разновидностей бипо-
лярных микросхем с комбинированной изоляцией. Широкое рас-
пространение получили микросхемы, создаваемые по изопланарной
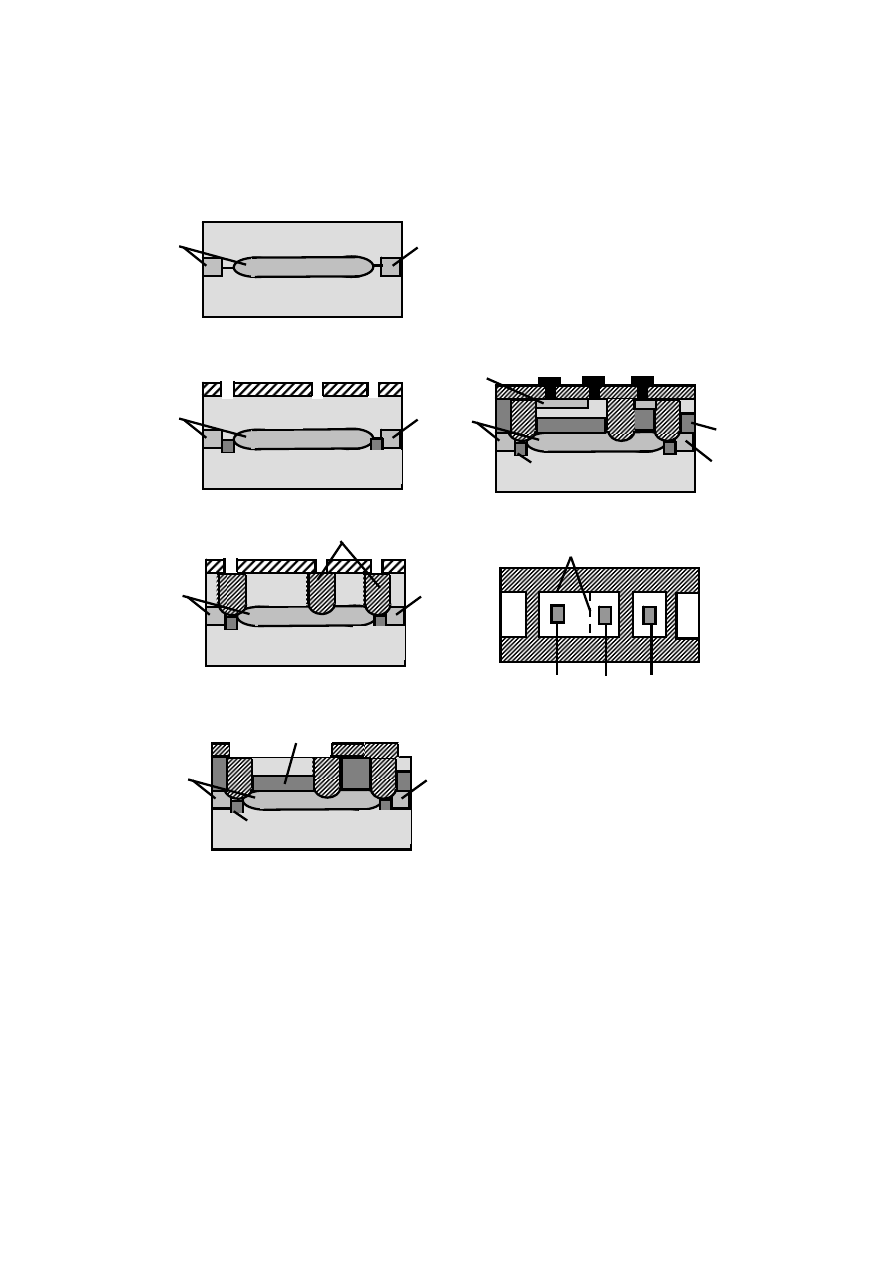
98
технологии. Последовательность основных технологических опе-
раций, используемых в изопланарной технологии, и структуру
изопланарного транзистора поясняет рис. 11.5.
n
p-
n+
n+
p+
n+
Э
Б
К
д
г
в
n
p-
n+
n+
Si
3
N
4
n
p-
n+
n+
p+
p+
SiO
2
Si
3
N
4
n
p-
n+
n+
p+
p+
p+
SiO
n
p-
n+
n+
p+
p+
Граница эмиттера
Э
Б
К
а
б
е
Рис. 11.5 — Комбинированная технология изоляции
В высокоомной подложке
p
−
-типа локальной диффузией до-
норов формируют скрытый
n
+
-слой. Затем на всей поверхности
пластины наращивают тонкий (
ЭП
W
= 1...3 мкм) эпитаксиальный
слой
n
-типа (рис. 11.5,
а
). На полученную поверхность наносят
слой нитрида кремния, из которого с помощью литографии фор-
мируют защитную маску. Не закрытые маской области эпитакси-
ального слоя подвергают травлению на глубину приблизительно

99
0,5
ЭП
W
. Локальным ионным легированием бором через маску со-
здают противоканальные области
p
+
-типа, расположенные под
вытравленными участками в подложке между скрытыми слоями
n
+
-типа соседних транзисторов (рис. 11.5,
б
). Назначение этих
областей поясняется ниже. Далее проводят селективное окисле-
ние кремния в вытравленных участках, где он не закрыт защит-
ной маской, так что нижняя граница окисленных областей попа-
дает в скрытый
n
+
-слой. Слой диоксида кремния растет как вниз,
так и вверх. Поэтому после окисления (при соответствующем
выборе глубины травления) восстанавливается почти плоская по-
верхность пластины (рис. 11.5,
в
). В результате образуются кар-
маны, в каждом из которых размещена структура
-
n n
+
-типа, изо-
лированная с боковых сторон толстым слоем диоксида кремния,
а снизу —
-
n p
+
−
переходом.
После этого пленку нитрида кремния удаляют и формируют
маску из слоя диоксида кремния, закрывающую те участки, в ко-
торых будут создаваться коллекторные контактные области
(рис. 11.5,
г
). Диффузией бора (или ионным легированием) полу-
чают базовый слой p-типа. При этом, независимо от точности сов-
мещения маски, боковые границы базового слоя совмещаются
с границами изолирующего диоксида кремния, так как он сам
также служит маской. Таким методом получают самосовмещен-
ную базу.
Различные методы самосовмещения, широко применяемые
в производстве современных микросхем, заключаются в исполь-
зовании элементов структуры, созданных на предыдущих этапах
изготовления микросхем, в качестве маски при последующем
формировании каких-либо областей. Затем восстанавливают слой
диоксида кремния на всей поверхности и создают из него маску,
используемую при диффузии (или ионном легировании) фосфора
в эмиттерную и контактную области
n
+
-типа. На этом этапе при-
меняют метод самосовмещения в плоскости кристалла — три гра-
ницы эмиттерной области (за исключением четвертой, обращенной
к базовому контакту) и все границы коллекторной контактной об-
ласти определяются изолирующим диоксидом, используемым вто-
рично в качестве маски. Вновь восстанавливают пленку диоксида

100
кремния на всей поверхности пластины, вытравливают в ней кон-
тактные отверстия, напыляют слой алюминия, проводят его селек-
тивное травление и создают эмиттерный, базовый и коллекторный
электроды и внутрисхемные соединения (рис. 11.5,
д
,
е
).
Главное достоинство изопланарного транзистора по сравне-
нию с эпитаксиально-планарным (см. рис. 11.1) состоит в том,
что при одинаковой площади эмиттерных переходов общая пло-
щадь изопланарного транзистора (с учетом площади изолирую-
щих областей) меньше почти на порядок. Поэтому на основе изо-
планарных транзисторов можно создавать БИС и СБИС. Столь
значительное снижение площади достигается в результате ис-
пользования более тонкого эпитаксиального слоя, что приводит
к уменьшению площади изолирующих областей. Кроме того,
в конструкции изопланарного транзистора исключены пассивные
области базы и коллектора, не используемые под контакты, так
как все боковые стенки базовой и три боковые стенки эмиттерной
области непосредственно граничат с изолирующим диоксидом
кремния транзисторов, что недопустимо.
11.3
Многоэмиттерные
транзисторы
Многоэмиттерные
n-р-n
транзисторы (МЭТ) отличаются
от рассмотренных выше одноэмиттерных прежде всего тем, что
в их базовой области
p
-типа создают несколько (обычно 4...8)
эмиттерных областей
n
+
-типа. Эти транзисторы используют
в микросхемах вместе с одноэмиттерными. Поэтому МЭТ изго-
товляют с помощью тех же технологических процессов, что и од-
ноэмиттерные, а структура МЭТ содержит те же полупроводни-
ковые слои и изолирующие области. Основная область примене-
ния многоэмиттерных транзисторов — цифровые микросхемы
транзисторно-транзисторной логики (ТТЛ). В этих микросхемах
они включаются на входе и выполняют логическую функцию ди-
одной сборки (рис. 8.7).
Многоэмиттерный транзистор можно представить в виде
совокупности отдельных
n-p-n
транзисторов, число которых рав-
но числу эмиттеров (рис. 11.6,
б
). Все базовые выводы этих тран-
зисторов, как и коллекторные, соединены между собой.